Типи корпусів мікросхем
Корпус інтегральної мікросхеми — це герметична несуча система і частина конструкції, призначена для захисту кристалу інтегральної схеми від зовнішніх впливів і для електричного з'єднання із зовнішніми колами за допомогою виводів.
Означення величин
Поверхневий монтаж
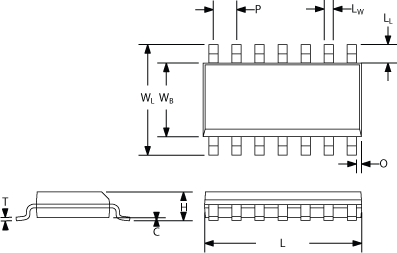 A general surface mount chip, with major dimensions. |
C Проміжок між корпусом і платою H Загальна висота (Height) T Товщина виводів L Загальна довжина (Len) LW Ширина виводу LL Довжина виводу P Відстань між центрами виводів (Pitch) WB Ширина (без виводів) WL Загальна ширина |
Монтаж в отвори
 A general through hole pin chip, with major dimensions. |
C Проміжок між корпусом і платою H Загальна висота T Товщина вивода L Загальна довжина LW Ширина виводу LL Довжина виводу P Відстань між центрами виводів (Pitch), або крок WB Ширина (тільки корпус) WL Загальна ширина |
Розміри в мм
Дворядні
| Зображення | Тип | Pin | Назва | Корпус | WB | WL | H | C | L | P | LL | T | LW |
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
 | DIP | Y | Dual Inline Package | 8-DIP | 6.2-6.48 | 7.62 | 7.7 | 9.2-9.8 | 2.54 (1/10 inch) | 3.05-3.6 | 1.14-1.73 | ||
| 32-DIP | 15.24 | 2.54 (1/10 inch) | |||||||||||
 | MSOP | Y | Mini Small Outline Package | 8-MSOP | 3 | 4.9 | 1.1 | 0.15 | 3 | 0.65 | 0.23 | 0.38 | |
 | SO SOIC SOP | Y | Small Outline Integrated Circuit | 8-SOIC | 3.9 | 5.8-6.2 | 1.72 | 0.10-0.25 | 4.8-5.0 | 1.27 | 1.05 | 0.19-0.25 | 0.39-0.46 |
| 14-SOIC | 3.9 | 5.8-6.2 | 1.72 | 0.10-0.25 | 8.55-8.75 | 1.27 | 1.05 | 0.19-0.25 | 0.39-0.46 | ||||
| 16-SOIC | 3.9 | 5.8-6.2 | 1.72 | 0.10-0.25 | 9.9-10 | 1.27 | 1.05 | 0.19-0.25 | 0.39-0.46 | ||||
| 16-SOIC | 7.5 | 10.00-10.65 | 2.65 | 0.10-0.30 | 10.1-10.5 | 1.27 | 1.4 | 0.23-0.32 | 0.38-0.40 | ||||
 | SOT | Y | Small Outline Transistor | SOT-23-8 | 1.6 | 2.8 | 1.45 | 2.9 | 0.65 | 0.6 | 0.22-0.38 | ||
 | SSOP | Y | Shrink Small-Outline Package | 16-SSOP | 5.3 | 7.8 | 2 | 6.2 | 0.65 | ||||
| TDFN | ? | Thin Dual Flat No-lead | 8-TDFN | 3 | 3 | 0.7-0.8 | 3 | 0.65 | N/A | 0.19-0.3 | |||
| TSOP I | Y | Thin Small-Outline Package | TSOP28/32 | 18.4 | 8 | 0.5 | |||||||
 | TSOP II | Y | Thin Small-Outline Package | TSOP32 | 10.2 | 21 | 1.27 | ||||||
| TSSOP | Y | Thin Shrink Small Outline Package | 8-TSSOP | 4.4 | 6.4 | 1.2 | 0.15 | 3 | 0.65 | 0.09-0.2 | 0.19-0.3 | ||
 | µSOP | Y | Micro Small Outline Package | 10-MSOP | 3 | 3 | 0.5 | ||||||
 | LLP (DFN) | Y | Leadless Leadframe Package | 10-LLP | 3 | 3 | 0.5 |
По чотирьох сторонах
| Image | Family | Pin | Name | Package | WB | WL | H | C | L | P | LL | T | LW |
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
 | PLCC | Y | Plastic Leaded Chip Carrier | 20-PLCC | 10 | 4.4 | 10 | 1.27 | N/A | ||||
| CLCC | N | Ceramic Leadless Chip Carrier | 48-CLCC | 14.22 | 14.22 | 2.21 | 14.22 | 1.016 | N/A | 0.508 | |||
| LQFP | Y | Low-profile Quad Flat Package | |||||||||||
 | TQFP | Y | Thin Quad Flat Pack | TQFP-44 | 10.00 | 12.00 | 0.35-0.50 | 0.80 | 1.00 | 0.09-0.20 | 0.30-0.45 | ||
 | LFCSP | N | Lead Frame Chip Scale Package | 0.5 | |||||||||
 | TQFN (MLPQ) | N | Thin Quad Flat No-lead (micro-leadframe package quad) |
Історія різних видів корпусів


Найперші інтегральні схеми пакувались в пласкі керамічні корпуси. Такий тип корпусів широко використовується військовими через його надійність і невеликий розмір. Комерційні мікросхеми перейшли на DIP (англ. Dual In-line Package), спочатку керамічний (CDIP), а потім пластиковий (PDIP). В 1980-х роках кількість контактів НВІС перевищила можливості DIP корпусів, що привело до розробки корпусів PGA (англ. pin grid array) і LCC (англ. leadless chip carrier). В кінці 80-х, з ростом популярності поверхневого монтажу, з'являються корпуси SOIC (англ. Small-Outline Integrated Circuit), які мають на 30-50% меншу площу і на 70% тонші, ніж DIP, і корпуси PLCC (англ. Plastic leaded chip carrier). В 90-х починається широке використання пластикових QFP і TSOP (англ. thin small-outline package) для ІС з великою кількістю виводів. Для складних мікропроцесорів, особливо для тих, які вставлялись в сокети, почали випускати PGA-корпуси. Intel і AMD перейшли від корпусів PGA до LGA (англ. land grid array, матриця контактних площинок).
Корпуси BGA (англ. Ball grid array) існують з 1970-х років. В 1990-х були розроблені корпуси FCBGA (BGA з перевернутим кристалом), які допускають набагато більшу кількість виводів, чим інші типи корпусів. В FCBGA кристал монтується в перевернутому вигляді і з'єднується з контактами корпуса через стовпчики (кульки) припою.
Монтаж методом перевернутого кристалу дозволяє розташовувати контактні площинки по всій площі кристалу, а не тільки по краях.
Активно розвивається подхід з розміщенням кількох чипів в одному корпусі, так звана «Система-в-корпусі» (англ. System In Package, SiP) або на загальній підкладинці, часто керамічній, так званий MCM (англ. Multi-Chip Module).
Посилання
- Packages
- Intersil packaging information
- ICpackage.org
- Solder Pad Layout Dimensions
- International Microelectronics And Packaging Society